Защитные диэлектрические пленки в планарной технологии
SiH4 + N2H4 Si (NH)2 + ЗНг
2Si (NH)2 — (SiN)2 NH + NH3
3 (SiN)2 NH — 2Si3N4 + NH3
При использовании реакции взаимодействия аммиака с силаном температура осаждения пленок нитрида кремния не может быть ниже 750°С. Применение гидразина вместо аммиака позволяет снизить рабочую температуру процесса до 550°С,.так как гидразин разлагается при более низких температурах. Осаждение пленок про
водят в кварцевой трубе, через которую пропускают газ-носитель и смесь силана с гидразином.

Рис. 9. Зависимость скорости осаждения пленок Si3N4 от температуры
На рис. 10 показана зависимость скорости осаждения пленок нитрида кремния от температуры для двух различных соотношений концентраций силана и гидразина.
Реакция взаимодействия тетрабромида кремния с азотом. Реакция осаждения нитрида кремния идет при температуре 950°С и имеет вид

Рис. 10. Зависимость скорости осаждения пленок S13N4 от температуры
На рис. 11 показана схема установки для проведения процесса нанесения пленок нитрида кремния на подложки с использованием рассмотренных реакций:
SiH4-T-NH3; SiCl4 + NHs; SiH4 + + N2H4; SiBr4 + N2.
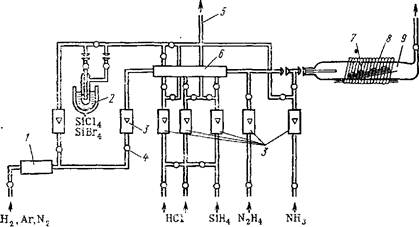
Рис. 11. Схема установки для осаждения пленок SіNi:
1 — блок очистки водорода; 2 — источник SiCI4 или SiBr4; 3 — ротаметры; 4 — краны: 5 — выпуск избыточных газов; S — смесительная камера; 7 — пластины; 4 — нагреватель: 9 — рабочая камера
11. Реактивное катодное осаждение пленок нитрида кремния
Достоинство этого метода состоит в том, что реакция между кремнием и азотом происходит при комнатной температуре окружающей среды за счет энергии газового разряда, между анодом и катодом в рабочей камере.
Нанесение пленок нитрида кремния проводят в специальных установках катодного распыления при постоянном токе с холодным или горячим катодом.
Для проведения процесса катодного осаждения используют катод из высокочистого кремния в виде плоской пластины большого (80—120 мм) диаметра. Анодом служит подложка. При подаче на катод высокого напряжения (1-—3 кВ) в пространстве между анодом и катодом возникает аномальный тлеющий разряд, который ионизирует газ внутри рабочей камеры. Специфика аномального тлеющего разряда состоит в том, что в непосредственной близости около катода образуется настолько сильное электрическое поле, что образовавшиеся при разряде положительно заряженные ионы газа, ускоряемые этим полем и бомбардирующие катод, выбивают из него не только дополнительные электроны (необходимые для поддержания разряда), но и атомы материала катода.
В течение этого процесса кремниевый катод постепенно разрушается. Поэтому в производственных условиях, когда процесс катодного распыления используется длительное время, катод подлежит замене после определенного срока службы.
Технологический процесс катодного осаждения пленок нитрида кремния включает в себя предварительную откачку воздуха из рабочей камеры с целью удаления имеющихся в воздухе загрязнений.
Откачку обычно проводят до давления 1,3· 10~3—1,3· 10~4 Па, а затем в рабочую камеру вводят смесь газов аргона и азота, предварительно очищенных от влаги и кислорода. Давление в рабочей камере при этом устанавливают равным 1,3—13 Па.
Азот, участвующий в процессе, является реактивным газом, а аргон используется для повышения эффективности процесса распыления. Требование по отсутствию кислорода в рабочей камере продиктовано тем, что кремний взаимодействует с кислородом значительно лучше, чем с азотом. Поэтому даже незначительное количество кислорода в рабочей камере приводит к образованию пленки диоксида кремния на поверхности подложки.
На процесс катодного осаждения оказывают влияние катодный ток и расстояние между анодом и катодом. При плотности катодного тока 0,2—0,8 мА/см2 и расстояния между анодом (подложкой) и катодом (пластина кремния) 2—5 см можно получить скорость осаждения нитрида кремния 0,01—0,05 мкм/мин.
Применение катода с поверхностью, большей или равной поверхности подложки, позволяет получать осажденные пленки нитряда кремния одинаковой толщины с разбросом, не превышающим 5%.
Реактивное ионно-плазменное осаждение пленок нитрида кремния является разновидностью катодного способа. Отличительной особенностью реактивного ионно-плазменного способа является то, что высокое отрицательное напряжение прикладывается не к катоду, а к дополнительному электроду, называемому мишенью. Отсюда следует, что и распыляемый материал (кремний) будет служить не катодом, а мишенью.
Второй отличительной особенностью является введение в рабочую камеру устройства для расположения подложек, на которые будет происходить осаждение нитрида кремния.
Третья особенность ионно-плазменного способа состоит в том, что в промежутке между подложкой и мишенью располагают анод и катод, между которыми создают несамостоятельный дуговой разряд. Для этого между анодом и катодом прикладывают напряжение порядка 100—300 В, а в рабочем объеме создают давление 0,13—0,013 Па. В этом случае катод эмитирует электроны, которые, взаимодействуя с рабочим газом, создают электронно-ионную плазму.
Положительные ионы плазмы бомбардируют кремниевую мишень и выбивают из нее атомы кремния. Выбитые из мишени, они реагируют с азотом, находящимся внутри рабочей камеры, и образуют нитрид кремния, который осаждается на подложке.
Таким образом, принципиальных различий между процессами катодного и ионно-плазменного осаждения нитрида кремния нет. Обычно различают лишь конструкции установок, которые характеризуют по числу рабочих электродов как двух- и трехэлектродные.
Начало и конец процесса осаждения пленок нитрида кремния определяются подачей и отключением высокого напряжения на мишени.
12. Контроль качества защитных диэлектрических пленок диоксида и нитрида кремния
При использовании защитных диэлектрических пленок SiO2 и Si3N4 в процессах планарной технологии подвергают контролю три основные характеристики: толщину пленки, наличие в ней сквозных отверстий (пористость) и количество дефектов на границе раздела кремний — защитная пленка.
Толщина защитной диэлектрической пленки является главным критерием, определяющим максимальную глубину проникновения легирующей примеси в полупроводниковые кристаллы при проведении процесса диффузии в планарной технологии.
Наличие сквозных отверстий (пор) в защитной пленке приводит к паразитному легированию исходной подложки и замыканию отдельных активных областей транзисторных структур интегральной микросхемы при проведении процессов локальной диффузии.
Количество дефектов на границе кремний — защитная пленка связано с плотностью зарядов на этой границе. Увеличение плотности зарядов приводит к ухудшению электрических параметров готовых полупроводниковых приборов и интегральных микросхем.
Таким образом, контроль рассмотренных характеристик защитных диэлектрических пленок позволяет оценить возможность их применения в последующих технологических процессах.
Другие рефераты на тему «Производство и технологии»:
- Проектирование двигательной установки и элементов конструкции второй ступени баллистической ракеты с ЖРД
- Модернизация поперечно–строгального станка с ходом ползуна 700 мм на базе модели 7307
- Проектирование редуктора
- Природные газы и индивидуальные углеводороды
- Кинематический расчет плоских шарнирных механизмов
Поиск рефератов
Последние рефераты раздела
- Технологическая революция в современном мире и социальные последствия
- Поверочная установка. Проблемы при разработке и эксплуатации
- Пружинные стали
- Процесс создания IDEFO-модели
- Получение биметаллических заготовок центробежным способом
- Получение и исследование биоактивных композиций на основе полиэтилена высокой плотности и крахмала
- Получение титана из руды
