Проекционная ФЛГ. Плазмохимическое осаждение
Достоинство проекционной литографии по сравнению с контакт ной состоит прежде всего в том, что исключается контакт фотошаблон: и полупроводниковой подложки, приводящий к образованию в них де фектов, кроме того, обеспечивается более низкая плотность дефекте! в формируемой маске фоторезиста.
В современной проекционной фотолитографии используются оптические системы, работающие в
условиях дифракционных ограничений. Это означает, что конструкция и технологи* изготовления проекционных объективов настолько совершенны, что их характеристики (разрешающая способность, точность воспроизведения размеров элементов) в основном определяются дифракционными эффектами, обусловленными значениями апертур, а не аберрациями.
Важнейшим параметром, характеризующим фотолитографические характеристики проекционного объектива, является числовая апертура NA = л sin а (где п — коэффициент преломления среды в пространстве изображения; в воздухе и — 1; а — половина максимального угла расходимости лучей, приходящих в точку изображения на оптической оси проекционной системы).
Для устранения хроматических аберраций используют мощный источник монохроматического актиничного света, в качестве которого может служить ртутная лампа сверхвысокого давления ДРШ-350 или ДРШ-500 (буквы обозначают Д -дуговая, Р - ртутная, Ш — шаровая, а цифры указывают номинальную электрическую мощность). Создают монохроматическое излучение с помощью специальных монохроматических полосовых фильтров и избирательно отражающих зеркал.
Схема осветительной системы проекционной установки показана на рисунке 5. Сотовый конденсор 4 значительно увеличивает равномерность освещенности по полю, так как каждая его линзочка проецирует попадающий на нее световой поток на все поле засветки. Таким образом неравномерный световой поток от лампы усредняется и выравнивается. Зеркало 5 е селективно отражающим покрытием пропускает тепловые лучи, но эффективно отражает ультрафиолетовое излучение, что способствует защите проекционной системы от мощного теплового потока, выделяемого лампой.
В условиях монохроматического и когерентного освещения разрешающая способность проекционной системы 6min = 31 X/(2NA), где X - длина волны актиничного излучения. Из этой формулы видно, что чем меньше длина волны актиничного излучения и больше числовая апертура объектива, тем выше его разрешающая способность, т. е. меньше размер передаваемого элемента изображения.
Существует еще один параметр проекционной системы — ее глубина резкости. Для компенсации аберраций оптической системы, искривления поверхности полупроводниковых подложек и изменения толщины слоя фоторезиста на их поверхности из-за сформированного технологического рельефа необходима вполне определенная (по возможности наибольшая) глубина резкости 5 = X/ [2(NA)2] . Из этой формулы видно, что чем больше числовая апертура, а это необходимо для увеличения разрешающей способности проекционной системы, тем меньше ее глубина резкости.
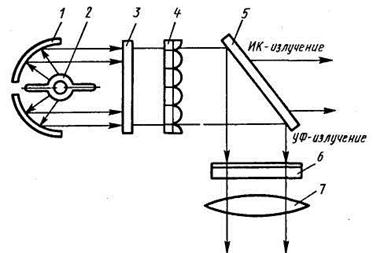
Рисунок 5. Схема осветительной системы проекционной установки:
1 - эллиптический отражатель, 2 - источник УФ-излучения, 3 - защитное стекло, 4 — сотовый конденсор типа "мушиный глаз", 5 - селективно отражающее зеркало, 6 - полосовой фильтр, 7 - конденсорная линза
Неправильная фокусировка может существенно влиять на качество передачи изображения проекционным методом. Поэтому проекционные установки снабжают высокоточными устройствами автофокусировки с точностью установки фокусного расстояния не хуже ± 0,2 мкм.
Правильная фокусировка, а также точная доза экспозиции - обязательные условия прецизионного переноса изображения на слой фоторезиста при проекционной фотолитографии.
Таким образом, видно, что необходим компромисс между разрешающей способностью, глубиной резкости, полем изображения и выбором числовой апертуры объектива.
Пиролитическое получение пленок из газовой фазы при нормальном и пониженном давлении
Пиролитическое осаждение используют для получения толстых слоев оксида кремния при низких температурах, когда термическое окисление неприемлемо из-за существенного изменения параметров предшествующих диффузионных слоев. Пиролитическое осаждение обеспечивает большую производительность, высокую равномерность слоев, качественное покрытие уступов металлизации и позволяет создавать изолирующие и пассивирующие слои не только на поверхности кремния, но и германия, арсенида галлия, а также других материалов. Помимо оксида кремния осаждают слои SiC, Si3N4, ФСС и поликремния.
При пиролитическом осаждении оксида кремния происходит термическое разложение сложных соединений кремния (алкоксисиланов) с выделением SiO2, например: тетраэтоксисилан
Si(OC2H5)4 650-700° С SiO2![]() + 2H2O + 4C2H4
+ 2H2O + 4C2H4
тетраметоксисилана
Si(OCH3)4 800-850°С SiO2 +2С2Н4+2Н2О или оксиление моносилана
SiH4+2O2 400-450° С Si02![]() + 2H20
+ 2H20
Последнюю реакцию обычно используют и при осаждении фосфорно-силикатного стекла с добавлением к газовой смеси фосфина РН3, разбавленного азотом до 1,5 %-ной концентрации. Фосфин вступает в реакцию с кислородом
4РН3 +5О2 => 2Р2О5 +6H2![]()
образуя оксид фосфора, который легирует SiO2. В пленке оксида кремния оказывается 1 - 3 % фосфора, за счет чего повышается ее термомеханическая прочность, пластичность и снижается пористость. При содержании фосфора до 8-9 % слои ФСС используют для планаризации поверхности пластин, имеющей рельеф.
ПЛАЗМОХИМИЧЕСКОЕ ОСАЖДЕНИЕ
При плазмохимическом осаждении (ПХО) процесс разложения кремнийсодержащих соединений активизируется высокочастотным (ВЧ) разрядом, образующим в газовой среде при пониженном давлении низкотемпературную кислородную плазму. Плазма состоит из атомов, радикалов, молекул в разных степенях возбуждения, а также электронов и ионов. Плазмохимическое осаждение обычно проводят при давлении в реакционной камере 66 - 660 Па и частоте ВЧ-разряда 13,56-40 МГц. Температура процесса более низкая, чем при пиролитическом осаждении, благодаря чему получаемый оксид кремния можно использовать для пассивации поверхности ИМС, так как не происходит взаимодействия кремния с металлом проводников.
Механизм образования пленок при ПХО состоит из трех основных стадий: образования в зоне разряда радикалов и ионов, адсорбции их на поверхности пленки SiO2 и перегруппировки адсорбированных атомов. Перегруппировка (миграция) адсорбированных поверхностью атомов и стабилизация их положения представляют важную стадию роста пленки.
Одновременно с образованием пленки происходит десорбция продуктов реакции с поверхности. Скорости десорбции и миграции атомов сильно зависят от температуры пластины, причем при большей температуре получаются пленки с меньшей концентрацией захваченных продуктов реакции, большей плотностью и более однородным составом.
Другие рефераты на тему «Коммуникации, связь и радиоэлектроника»:
- Проект строительства линейных сооружение районной АТС
- Шестнадцатиразрядные микроконтроллеры серии 296 фирмы Intel. Их сравнение по возможностям и быстродействию с современными микроконтроллерами серии MB90 фирмы Fujitsu
- Схемотехника основных блоков радиопередающего устройства
- Пеленгатор постановщиков активных помех
- Установка аудиосистемы (внутренний тюнинг)
Поиск рефератов
Последние рефераты раздела
- Микроконтроллер системы управления
- Разработка алгоритмического и программного обеспечения стандарта IEEE 1500 для тестирования гибкой автоматизированной системы в пакете кристаллов
- Разработка базы данных для информатизации деятельности предприятия малого бизнеса Delphi 7.0
- Разработка детектора высокочастотного излучения
- Разработка микропроцессорного устройства для проверки и диагностики двигателя внутреннего сгорания автомобиля
- Разработка микшерного пульта
- Математические основы теории систем
