Виды испарений и распылений в технологии ЭОТ
Недостатки этих испарителей - сложность аппаратуры питания и управления, трудность испарения металлов высокой теплопроводности (медь, алюминий, серебро, золото) из водоохлаждаемого тигля, необходимость частой замены и юстировки катода, а также питание высоким напряжением, что требует соблюдения соответствующих правил техники безопасности.
Катодное распыление
Ионное распыление, ра
зрушение отрицательного электрода (катода) в газовом разряде под действием ударов положительных ионов. В более широком смысле - разрушение твёрдого вещества при его бомбардировке заряженными или нейтральными частицами.
К.р., с одной стороны, нежелательное явление, уменьшающее срок службы электровакуумных приборов; с др. стороны, К.р. имеет практическое применение для очистки поверхностей, выявления структуры вещества (ионное травление), нанесения тонких плёнок, для получения направленных молекулярных пучков и т.д. Бомбардирующие ионы, проникая в глубь мишени, вызывают смещение её атомов. Эти смещенные атомы, в свою очередь, могут вызывать новые смещения и т.д. Часть атомов при этом достигает поверхности вещества и выходит за её пределы. При определённых условиях частицы могут покидать поверхность мишени в виде ионов. В монокристаллах наиболее благоприятные условия для выхода частиц складываются в направлениях, где плотность упаковки атомов наибольшая. В этих направлениях образуются цепочки соударений (фокусоны), с помощью которых энергия и импульс смещенных частиц передаются с наименьшими потерями. Существенную роль при К.р. играет процесс каналирования ионов, определяющий глубину их проникновения в мишень К.р. наблюдается при энергии ионов E выше некоторой величины E0, называемым порогом К.р. Значения E0 для различных элементов колеблются от единиц до нескольких десятков эв. Количественно К.р. характеризуется коэффициентом распыления S, равным числу атомов, выбитых одним ионом. Вблизи порога S очень мало (10–5 атомов/ион), а при оптимальных условиях S достигает нескольких десятков. Величина S не зависит от давления газа при малых давлениях р < 13,3 н/м2 (0,1 мм рт. ст), но при р > 13,3 н/м2 (0,1 мм рт. см) происходит уменьшение S за счёт увеличения числа частиц, осаждающихся обратно на поверхность. На величину S влияют как свойства бомбардирующих ионов - их энергия Ei (Рисунок 4 а), масса Mi (Рисунок 4 б), угол падения ее на мишень (Рисунок 4 в), так и свойства распыляемого вещества - чистота поверхности, температура, кристаллическая структура, масса атомов мишени.
Угловое распределение частиц, вылетающих с распыляемой поверхности, анизотропно. Оно зависит от энергии ионов, а для монокристаллов также от типа кристаллической решётки и строения распыляемой грани. Осадок из распыляемого вещества, образующийся на экране, имеет вид отдельных пятен, причём симметрия картины осадка та же, что и симметрии распыляемой грани и образовавшихся на ней в результате К.р. фигур травления (Рисунок 4 г). Энергии распылённых частиц колеблются от нескольких долей эв до величин порядка энергии первичных ионов. Средние энергии распыляемых частиц составляют обычно десятки эв и зависят от свойств материала мишени и характеристик ионного пучка

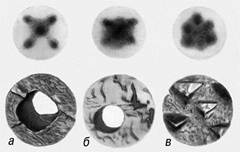

а) б) в)
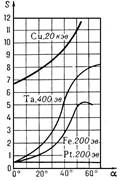
г)
Рисунок 4 а-г
Высокочастотное распыление. Реактивное распыление
Для высокочастотного и реактивного ионного распыления используют как обычные диодные, так и магнетронные системы.
Высокочастотное распыление начали применять, когда потребовалось наносить диэлектрические пленки. В предыдущей главе предполагалось, что распыляемое вещество - металл. При этом ударяющийся о мишень ион рабочего газа нейтрализуется на ней и возвращается в вакуумный объем рабочей камеры.
Если же распыляемый материал - диэлектрик, то положительные ионы не нейтрализуются и за короткий промежуток времени после подачи отрицательного потенциала покрывают слоем мишень, создавая на ее поверхности положительный заряд. Поле этого заряда компенсирует первоначальное поле мишени, находящейся под отрицательным потенциалом, и дальнейшее распыление становится невозможным, так как ионы из разряди но притягиваются к мишени.
Для того чтобы обеспечить распыление диэлектрической мишени, приходится нейтрализовать положительный заряд на ее поверхности подачей высокочастотного (ВЧ) переменного потенциала. При этом в системе распыления, которая представляет собой диодную систему (Рисунок 5, а, б) с катодом 2, окруженным экраном 1 (анодом может служить вакуумная камера), происходят следующие процессы.
Так как в плазме положительного столба 4 содержатся равные количества иолов и электронов, при переменной поляризации мишени по время отрицательного полупериода (Рисунок 5, а) она притягивает ионы 3. Ускоренные ионы бомбардируют и распыляют диэлектрическую мишень, одновременно передавая ей свой заряд. При этом мишень накапливает положительный заряд и интенсивность распыления начинает снижаться. Во время положительного полупериода (Рисунок 5, б) мишень притягивает электроны 5, которые нейтрализуют заряд ионов, превращая их в молекулы 6. В следующие отрицательный и положительный полупериоды процессы повторяются и т.д.
В промышленных установках ВЧ распыление ведется на единственной разрешенной частоте 13,56 МГц, которая находится в диапазоне радиосвязи. Поэтому иногда ВЧ распыление называют радиочастотным.
Реактивное распыление применяют для нанесения пленок химических соединений (оксидов, нитридов). Требуемое химическое соединение получают, подбирая материал распыляемой мишени и рабочий газ.
При этом методе в рабочую камеру в процессе распыления вводят дозированное количество так называемых реактивных (химически активных) газов. Причем для нанесения пленок оксидов и нитридов в рабочий газ - аргон - добавляют соответственно кислород и азот. Основными условиями при получении требуемых соединений является тщательная очистка реагентов и отсутствие натекания, а также газовыделения в камере.
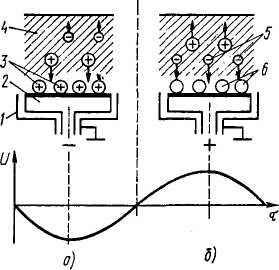
Рисунок 5. Схемы высокочастотного распыления при отрицательном (а) и положительном (б) полупериодах напряжения:
7 - экран, 2 - катод, 3 - ионы, 4 - плазма, 5 - электроны, б - молекулы
Недостаток реактивного распыления - возможность осаждения соединений на катоде, что существенно уменьшает скорость роста пленки.
При реактивном распылении реакции могут протекать как на мишени, так и в растущей пленке, что зависит от соотношений реактивного газа и аргона. В отсутствие аргона реакции происходят на мишени. При этом разряд протекает вяло, так как большинство атомов реактивного газа расходуется на образование на поверхности мишени соединений, которые препятствуют распылению. Чтобы реактивные процессы проходили на подложке, количество реактивного газа не должно превышать 10%; остальное составляет аргон.
Другие рефераты на тему «Производство и технологии»:
- Получение биметаллических заготовок центробежным способом
- Заготовки - понятия, способы получения
- Получение и исследование биоактивных композиций на основе полиэтилена высокой плотности и крахмала
- Микроскопическое исследование древесины и целлюлозных волокон
- Деятельность Ивановского меланжевого комбината
Поиск рефератов
Последние рефераты раздела
- Технологическая революция в современном мире и социальные последствия
- Поверочная установка. Проблемы при разработке и эксплуатации
- Пружинные стали
- Процесс создания IDEFO-модели
- Получение биметаллических заготовок центробежным способом
- Получение и исследование биоактивных композиций на основе полиэтилена высокой плотности и крахмала
- Получение титана из руды
