Исследование вольт-фарадных характеристик многослойных структур на кремниевой подложке
Рис. 4. Простейшая эквивалентная схема МДП структуры
При экспериментальном измерении вольт-фарадных характеристик МДП-структур важное значение имеет частота измерительного сигнала ω. Это связано с тем, что процессы захвата и выброса на поверхностные состояния, а также изменения заряда свободных носителей в инверсионном слое, характеризующие соответствующие емкости Css и Csc, име
ют конечные времена τ, сравнимые с периодом обычно используемого в эксперименте сигнала. Напомним, что изменение заряда Qn в инверсионном слое характеризуется генерационно-рекомбинационным процессом и определяется временем жизни неосновных носителей τ в ОПЗ. Характерное время захвата и выброса на поверхностные состояния определяется постоянной времени τ этих состояний.
На рисунке 5 приведены равновесные C-V кривые идеальных МДП-структур с разной толщиной диэлектрика, рассчитанные теоретически.

Рис. 5. Равновесные C-V характеристики идеальных МДП-структур на кремнии p-типа с различной толщиной подзатворного диэлектрика
Описание зависимости емкости от напряжения мы начнем рассматривая левую часть кривой. (приложенное напряжение отрицательно)., где происходит аккумуляция дырок и соответственно наблюдается высокая емкость полупроводника. В итоге полная емкость определяется емкостью изолятора. При убывании отрицательного смещения вблизи поверхности образуется обедненная область, действующая как диэлектрик, включенный последовательно с изолятором, полная емкость при этом уменьшается. Далее емкость проходит через минимум и может снова начать возрастать, в зависимости от способности электронов следовать за изменениями приложенного переменного сигнала. Это возможно только при низких частотах (5-100 Гц), когда скорость генерации- рекомбинации неосновных носителей (в нашем случае электронов) достаточна для изменения заряда в инверсионном слое.
Многослойная МДП-структура.
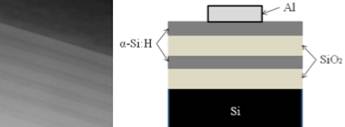
Рис.6. Многослойная структура Si(6нм)/SIO2(10нм)(слева).
Рассмотрим зонную диаграмму для многослойных структур на примере двухслойной и поймем их отличие от классических.

Рис.7. Многослойная структура без напряжения на затворе.

Рис.8. Многослойная структура с малым напряжением на затворе.
На рисунке 8 видно, что при малых напряжениях слой полупроводника между диэлектриками не заряжен и все пространство d структуры работает как диэлектрик.

Рис.9. Многослойная структура с большим напряжением на затворе
При увеличении напряжения вероятность туннелирования электронов из внешнего полупроводника через слой диэлектрика повышается, слой между диэлектриками заряжается и емкость структуры теперь определяется емкостью лишь одного слоя диэлектрика. В результате емкость структуры увеличивается. В следствии этого мы имеем, что емкость структуры зависит от глубины проникновения носителей заряда в многослойную структуру.
2. Описание установки
В эксперименте использовался прибор Agilent E4980A.
Четырехпроводной метод измерения
Схема измерения, показанная на рис. 10., позволяет исключить влияние паразитных индуктивностей, интерференции сигналов и других остаточных эффектов на измерение, особенно существенное на высоких частотах. Благодаря виртуальному заземлению потенциальных выводов, по внешним экранам кабелей протекает ток равный току по внутреннему проводу и противоположно направленный, в результате исчезает магнитное поле снаружи провода и взаимная индуктивность проводов. Естественно, подводящие к образцу провода (нескомпенсированная часть должны быть как можно короче, как и длина кабелей).
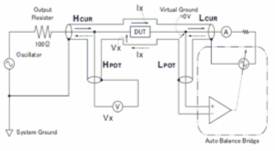
Рис.10. Схема четырехпроводного метода измерения.
DUT (device under test) –измеряемый импеданс.
3. Экспериментальная часть
Полученные данные
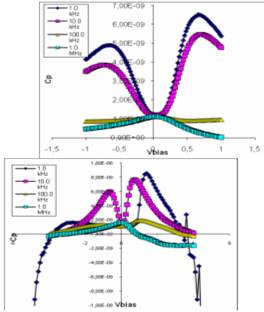
Рис. 11. Вольт-фарадная характеристика образца 4 HD Si
Алюминиевые контакты без отжига.
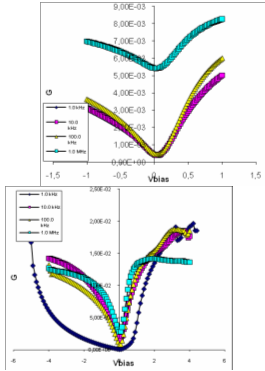
Рис. 12. G-V характеристика образца 4 HD Si
Алюминиевые контакты без отжига.
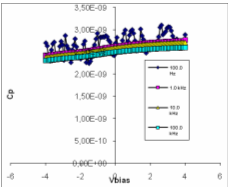
Рис. 13. Вольт-фарадная характеристика образца 4 HD Si
С отожженными алюминиевыми контактами.
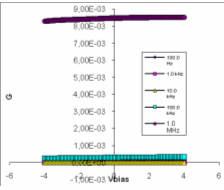
Рис. 14. G-V характеристика образца 4 HD Si
С отожженными алюминиевыми контактами.
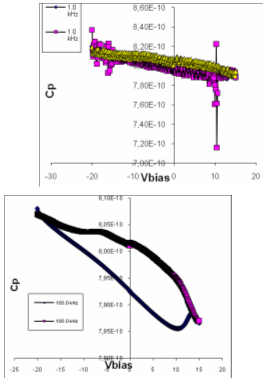
Рис. 15. Вольт-фарадная характеристика образца HD Sip O2
С отожженными алюминиевыми контактами.
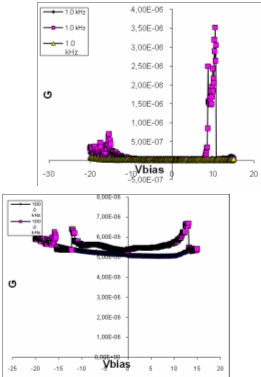
Рис. 16. G-V характеристика образца HD Sip O2
С отожженными алюминиевыми контактами.
4. Описание погрешностей
Источниками погрешностей являются неравные условия измерения- возможные разности температур образцов и интенсивности освещения. Погрешности измерительного прибора скомпенсированы и пренебрежимо малы.
Выводы и результаты
Полученные данные характеризуют поведение емкостей образцов в зависимости от напряжения, приложенного к затвору.
Положительные участки дифференциальной проводимости свидетельствуют о наличии туннельных явлении.
Список литературы
1. Сивухин Д.В. Общий курс физики. М.:Наука,1977. Т. 3.
2. Ансельм А.И. Введение в теорию полупроводников М.:Наука,1978
3. Бонч-Бруевич В.Л. Физика полупроводников М.:Наука,1990
Другие рефераты на тему «Физика и энергетика»:
Поиск рефератов
Последние рефераты раздела
- Автоматизированные поверочные установки для расходомеров и счетчиков жидкостей
- Энергосберегающая технология применения уранина в котельных
- Проливная установка заводской метрологической лаборатории
- Источники радиации
- Исследование особенностей граничного трения ротационным вискозиметром
- Исследование вольт-фарадных характеристик многослойных структур на кремниевой подложке
- Емкость резкого p-n перехода
