Атомно-силовая микроскопия
Содержание
1. Введение
2. Принципиальное устройство микроскопа АСМ
2.1 Атомно-силовой микроскоп
2.2 Способы сканирования
3. Исследование механических свойств полимерных пленок
3.1 Исследование деформированой поверхности
3.2 Необходимость. Проблематика
4. Сканирующий туннельный микроскоп
4.1 Открытие
4.2 Преимущества и недостатки ска
нирующей зондовой микроскопии по отношению к другим методам диагностики поверхности
4.3 Режимы сканирования
5. Применение АСМ
6. Перспективы
Литература
1. Введение
Разрешающая способность человеческого глаза - около 100 микрометров (0,1 мм), что примерно соответствует толщине волоска. Чтобы увидеть более мелкие предметы, требуются специальные устройства. Изобретенный в конце XVII века микроскоп открыл человеку новые миры, и в первую очередь мир живой клетки. Но у оптического микроскопа есть естественный физический предел разрешения - длина волны света, и этот предел (приблизительно равный 0,5 мкм) был достигнут к концу XIX века. Следующим этапом погружения в глубь микромира стал электронный микроскоп, в котором в роли луча света выступает пучок электронов. Его разрешение достигает нескольких ангстрем (0,1 нм), благодаря чему ученым удалось получить изображение вирусов, отдельных молекул и даже атомов. Но и оптический и электронный микроскоп дают лишь плоскую картинку[1].

Рис.1
Увидеть трехмерную структуру микромира удалось только тогда, когда на смену оптическому лучу пришла тончайшая игла. Вначале принцип механического сканирования с помощью микрозонда нашел применение в сканирующей туннельной микроскопии, а затем на этой основе был разработан более универсальный метод атомно-силовой микроскопии. Атомно-силовая микроскопия позволяет анализировать на атомном уровне структуру самых разных твердых материалов - стекла, керамики, пластиков, металлов, полупроводников. Измерение можно проводить не только в вакууме, но и на воздухе, в атмосфере любого газа и даже в капле жидкости. Этот метод незаменим и для исследования биологических объектов[1].
Суть метода.
Суть метода заключается в том, что пучок электронов, взаимодействуя с поверхностью, рассеивается на ней и регистрирует её структуру, он может проходить образец насквозь — ПЭМ, или отражаться ОЭМ[2].
Устройство микрозонда.
Микрозонд представляет собой тонкую пластинку-консоль (ее называют кантилевером, от английского слова "cantilever" - консоль, балка). На конце кантилевера расположен острый шип (радиус закругления от 1 до 10 нм). При перемещении микрозонда вдоль поверхности образца острие шипа приподнимается и опускается, очерчивая микрорельеф поверхности, подобно тому, как скользит по грампластинке патефонная игла. На выступающем конце кантилевера (над шипом) расположена зеркальная площадка, на которую падает и от которой отражается луч лазера. Когда шип опускается и поднимается на неровностях поверхности, отраженный луч отклоняется, и это отклонение регистрируется фотодетектором. Данные фотодетектора используются в системе обратной связи, которая обеспечивает постоянную силу давления острия на образец. Пьезоэлектрический преобразователь может регистрировать изменение рельефа образца в режиме реального времени. В другом режиме работы регистрируется сила взаимодействия острия с поверхностью при постоянном положении шипа над образцом. Микрозонд обычно делают из кремния или нитрида кремния. Разрешающая способность метода составляет примерно 0,1-1 нм по горизонтали и 0,01 нм по вертикали. Смещая зонд по горизонтали, можно получить серию рельефов и с помощью компьютера построить трехмерное изображение[1,4].
При использовании атомно-силовой микроскопии не требуется, чтобы образец проводил электричество. Благодаря этому атомно-силовая микроскопия нашла широкое применение для анализа биологических объектов - кристаллов аминокислот, белков, клеточных мембран и многого другого[1].
В лаборатории, где занимаются исследованиями, имеется уникальный сверхвысоковакуумный отражательный электронный микроскоп, позволяющий проводить in-situ эксперименты с полупроводниковыми материалами и имеющий только один аналог в мире в Японии. Также есть микроскопия высокого разрешения на базе ПЭМ Jeol-4000[2].
2. Принципиальное устройство микроскопа АСМ
Сканирующая зондовая микроскопия — это метод исследования поверхности, основанный на взаимодействии микрозонда (кантилевера в случае АСМ) с поверхностью образца. Микрозонд или кантилевер (англ. — балка) представляет собой кремниевую пластинку (3х1.5х0.3 мм) с торчащей из торца балкой (как прямоугольной, так и треугольной формы), — на конце балки находится шип, конец которого и зондирует поверхность[3].
2.1 Атомно-силовой мікроскоп
Одной из наиболее распространенных разновидностей «сканирующей зондовой микроскопии», является атомно-силовая микроскопия (Рис. 1).
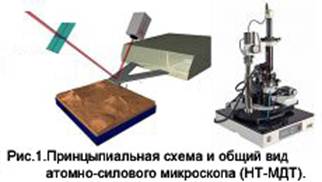
Первый микроскоп такого типа был сконструирован Г. Биннигом, Х. Гербером и С. Квайтом в 1986 году, после того как годом ранее Г. Бинниг показ принципиальную возможность неразрушающего контакта зонда с поверхностью образца[2].
Кантилеверы разделяются на жёсткие и мягкие, — по длине балки, а характеризуется это резонансной частотой колебаний кантилевера. Процесс сканирования микрозондом поверхности может происходить как в атмосфере или заранее заданном газе, так и в вакууме, и даже сквозь плёнку жидкости. СЗМ измеряет как нормальное к поверхности отклонение зонда (субангстремное разрешение) так и латеральное — одновременно. Для детектирования отклонения используется полупроводниковый лазер с длинной волны 670 нм и оптической мощностью 0,9 мВт. Лазерный луч направляется на обратную к по отношению к поверхности сторону кантилевера (на самый кончик), которая покрыта специальным алюминиевым зеркальным слоем для наилучшего отражения, и отраженный луч попадает в специальный четырёхсекционный фотодиод. Таким образом, отклонения кантилевера приводят к смещению луча лазера относительно секций фотодиода, — изменение разностного сигнала с фотодиода и будет показывать амплитуду смещения кантилевера в ту или иную сторону. Такая система позволяет измерять отклонения лазера в угле 0,1", что соответствует отклонению кантилевера на угол 2•10–7 рад[2,5].
2.2 Способы сканирования
Сканирование поверхности может происходить двумя способами, — сканирование кантилевером и сканировение подложкой. Если в первом случае движения вдоль исследуемой поверхности совершает кантилевер, то во втором относительно неподвижного кантилевера движется сама подложка. Для сохранения режима сканирования, — кантилевер должен находиться вблизи поверхности, — в зависимости от режима, — будь то режим постоянной силы, или постоянной высоты, существует система, которая могла бы сохранять такой режим во время процесса сканирования. Для этого в электронную схему микроскопа входит специальная система обратной связи, которая связана с системой отклонения кантилевера от первоначального положения. Уровень связи (рабочая точка) кантилевер—подложка задается заранее, и система обратной связи отрабатывает так, чтобы этот уровень поддерживался постоянным независимо от рельефа поверхности, а сигнал, характеризующий величину отработки и является полезным сигналом детектирования[2,5].
Другие рефераты на тему «Производство и технологии»:
Поиск рефератов
Последние рефераты раздела
- Технологическая революция в современном мире и социальные последствия
- Поверочная установка. Проблемы при разработке и эксплуатации
- Пружинные стали
- Процесс создания IDEFO-модели
- Получение биметаллических заготовок центробежным способом
- Получение и исследование биоактивных композиций на основе полиэтилена высокой плотности и крахмала
- Получение титана из руды
